
 |
|
Главная Усиленная люминесценция [0] [1] [2] [3] [4] [5] [6] [7] [8] [9] [10] [11] [ 12 ] [13] [14] [15] [16] [17] [18] [19] [20] [21] [22] [23] [24] [25] [26] [27] [28] [29] [30] [31] [32] [33] [34] [35] [36] [37] [38] [39] [40] [41] [42] [43] [44] [45] [46] [47] [48]  Рис. 2.3. Схема лазерных гетероструктур иа основе твердых растворов AlAs - GaAs {xi, Х2, хз - значения х в формуле ALGai-.rAs, xi> xo<Cx.i): а - простой /7 - п-гетеропереход. б - односторонняя гетероструктура с р - л-переходом в материале дг- и р - р-гетеропереходом, создающим потенциальный барьер для инжек-тируемы.ч электронов; в - двусторонняя гетероструктура с р - р- и р - п-гетеро-переходами. г - двусторонняя гетероструктура с р - п-переходом в материале и двумя гетеропереходами; д-гетероструктура с разде.1ьными электронным и оптическим ограничениями. Под гетероструктурами приведены упрощенные графики пространственного изменения ширины запрещенной зоны полупроводников. Величина скачка запрещенной зоны AEg равна сумме разрывов дна зоны проводимости АЕсо и потолка валентной зоны АЕ. AEg = AEca + AE,o. (2.12) Для гетеропереходов GaAs-GaP установлено: АЕсо = = 0,67 эВ, А£„о = 0,15 эВ, A£g = 0,82 эВ. В гетеропереходах ALGai-As-GaAs разрыв валентной зоны практически отсутствует, поэтому A£g = А£с0,7б эВ. Как показано Ж. И. Алферовым с сотрудниками, для создания лазерных гетеропереходов наиболее подходящей оказалась пара полупроводников AlAs-GaAs, так как постоянные кристаллической решетки этих материалов (oi =0,565 нм для GaAs и аг = 0,566 нм для AlAs) весьма близки. В инжекционных лазерах используется несколько типов гетероструктур на основе AUGai-xAs-GaAs. Простейшей из них является гетероструктура с одним р - п-гетеропереходом (рис. 2.3, а), в которой р-область характеризуется большей шириной запрещенной зоны, чем п-область, поскольку для нее берется xi> Х2 (Eg растет с увеличением значения х в формуле Alj:Gai-.vAs). Односторонняя гетероструктура состоит из р - р-гетеро-перехода (xi> Х2) и р - п-перехода в узкозонном материале (рис. 2.3,6). В двусторонней гетероструктуре два гетероперехода, причем Х1Яхз>Х2 (рис. 2.3, в). В моди-  Рис. 2.4. Зонная диаграмма лазерной двусторонней гете-роструктуры (см. рис. 2.3, в) при термодинамическом равновесии (а) и в режиме генерации (б) фицированной двойной гетероструктуре между р - р-и п - л-гетеропереходами создается узкозонный р - п-переход (рис. 2.3, г). В гетероструктурах с раздельными оптическим и электронным ограничениями излучение распространяется в слоях Х3Х2Х2ХЛ, а носители заряда рекомбинируют в более тонком слое Х2Х2. По сравнению с простыми р - л-переходами гетеро-структуры, особенно двусторонние, обладают двумя важными преимуществами, которые обеспечивают более низкий порог генерации при комнатной температуре. Во-первых, ширина запрещенной зоны в активной области двусторонней гетероструктуры меньше, чем Eg в пассивных областях. Поэтому инжектированные в активную область носители находятся в потенциальной яме. Потенциальные барьеры гетеропереходов препятствуют растеканию области рекомбинации за пределы активного слоя (электронное ограничение). В то же время в гомо-лазерах область рекомбинации, т. е. объем кристалла, где рО и пфО, может быть значительно больше активного слоя (см. рис. 2.2, е). Во-вторых, гетероструктуры обладают значительно лучшими волноводными свойствами, чем активный слой р - /i-перехода (оптическое ограничение). Вследствие ограничения активной области потенциальными барьерами в гетеролазерах стало возможным явление суперинжекции, заключающееся в создании в активной области концентрации носителей более высокой, чем равновесная концентрация этих же носителей в эмиттере. На рис. 2.4 показано, как квазиуровень Ферми, находившийся при термодинамическом равновесии ниже дна зоны проводимости, в результате суперинжекции заходит в зону проводимости. Поэтому в гетеролазерах отпадает необходимость применять сильное легирование, которое сопровождается появлением в активной области большой концентрации дефектов. Активная зона гомолазера неоднородна (см. рис. 2.2). Она характеризуется градиентами концентраций электронов и дырок и зависимостью коэффициента усиления от координаты х. В гетеролазерах активный слой более однороден. Широкое распространение получили гетеролазеры с полосковым контактом, в которых активная среда создается в виде отдельной нити диаметром до 1 мкм, что обеспечивает стабильную одномодовую генерацию при весьма низком пороге, порядка миллиампера. В простейшем случае для получения полоскового лазера на выращенную гетероструктуру наносится слой изолирующего материала, например диоксида кремния ЗЮг. В этом слое протравливается полоска и наносится омический контакт (рис. 2.5, а). Второй контакт остается широким, поэтому происходит некоторое растекание тока за пределы активной области, расположенной под полосковым контактом. Вместо изолирующего материала используются также запорные свойства р - /г-переходов при подаче на них напряжения в обратном направлении (плюс околр «-типа). В этом случае проводится диффузия акцепторной примеси, в частности цинка, через маску в /г-слой для получения полоски полупроводника р-типа и ликвидации в этом месте обратно смещенного р - /г-перехода {рис. 2.5,6). Чтобы улучшить волноводные свойства гетероструктуры в подложке из GaAs, под активной областью делается канавка, заращиваемая потом более широкозонным материалом AlGaAs. Для ограничения электромагнитной волны в плоскости р - /г-перехода и уменьшения внутренних оптических потерь создаются гетероструктуры с террасной подложкой (рис. 2.5, в). Растекание тока в боковом направлении можно практически исключить, если часть гетероструктуры за пределами полоски стравить и нанести изолирующее покрытие не только сверху, но по бокам активной области (мезополосковая структура). Используется также заращенная мезополосковая структура, в которой активный узкозонный слой со всех сторон окружен широкозонными слоями AlGaAs, что уменьшает внутренние потери генерируемого излучения (рис. 2.5, г). Наиболее узкую полоску активной области можно получить с помощью К-образной гетероструктуры (рис. 2.5, д). 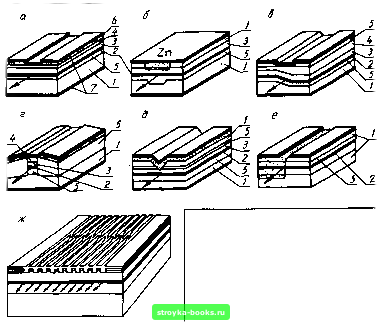 Рис. 2.5. Гетеролазеры на основе AlGaAs с полосковым контактом: а-планарная структура; 6-подложка с канавкой; в - террасная подложка; г - заращенная мезаполосковая структура; д-У-образная структура; е-структура с поперечным р - л-переходом; ж - многоэлементный фазированный лазер (фазированная лазерная решетка); / - л-GaAs; 2 -p-GaAs (активный слой); Л - р-AlGaAs; 4 - p-GaAs; 5 - л-AlGaAs; 6 - SiOz; 7 - контакты. Стрелками указаны направления распространения генерируемого излучения, точками - области диффузнн Zn Если одну часть гетероструктуры легировать цинком, то получится обычный р - /г-переход в поперечном направлении в GaAs (рис. 2.5, е). Ширина р - /г-перехода определяется толщиной слоя GaAs. Полосковый лазер можно также изготовить путем нанесения на поверхность гетероструктуры полоскового металлического контакта и последующей обработки всей поверхности потоком протонов. Не защищенные металлом участки становятся высокоомными из-за образования радиационных дефектов. Для увеличения мощности генерации созданы многоэлементные фазированные инжекционные лазеры, или фазированные лазерные решетки (рис. 2.5, ж). В пределах единой гетероструктуры интегрируется несколько десятков полосковых лазеров, потоки излучения которых взаимодействуют между собой, что приводит к когерентному сложению интенсивностей. Одновременно уменьшается угол расходимости излучения в плоскости гетероперехода. Жесткие фазовые соотношения между отдельными лучами устанавливаются либо за счет перекрытия электромагнитных полей соседних лазеров, либо, как показано на рис. 2.5, ж, в результате разветвления в лазерных волноводах. Квантоворазмерные структуры (КРС). Слои, толщина которых сравнима с длиной волны де Бройля для электронов или дырок или меньше ее, называются квантовораз-мерными. В обычных гетероструктурах толщина слоев не меньше 0,05 мкм (500 А), что значительно больше длины волны де Бройля /.Б=у, (2.13) где р - импульс электрона. Поэтому их свойства совпадают со свойствами объемных кристаллов. В 80-х гг. разработаны утонченные методы молекулярной, газофазовой и жидкофазовой эпитаксии, позволяющие получать высокосовершенные структуры с толщиной слоев менее 10 нм. В таких слоях возникают ограничения для движения электронов и дырок в направлении, перпендикулярном к поверхности слоя, что сопровождается изменением квантовомеханических свойств слоя. В частности, если в массивном образце функция плотности состояний электрона имеет вид параболы (рис. 2.6, а), то в квантоворазмерном слое она выражается ступенчатой кривой. Путем изготовления нитей и кубиков субмикронной толщины (рис. 2.6, б, в) можно создать ограничения движению электронов в двух и трех измерениях. Тогда функция плотности состояний вообще теряет сходство с этой характеристикой для массивного образца. Квантоворазмерные структуры приводят к квантованию состояний электрона, подобно тому как они квантуются периодическим потенциалом криста.лла. В случае одномерного ограничения в одном слое возникает набор дискретных состояний проекции волнового вектора на направление норма.т к слою {к, квантуется, см. рис. 2.6, а).  Рис. 2.6. Квантоворазмерные структуры: а - сверхтонкие слон (одномерное ограничение вдоль оси 2); 6 - субмикроиные нити (ограничения вдоль осей х н г); в - субмикронные кубики (трехмерное ограничение). Внизу соответствующие графики плотности состояний в зоне проводимости. Штриховая парабола - график g{E,) массивного образца Собственные значения энергии носителя в одном квантоворазмерном слое выражаются формулой Е(п, Кх, Ку) =Еп+ (K-f/с), где Еп - собственные значения энергии, нормальной составляющей (вдоль оси z) гамильтониана; т* - эффективная масса носителя; /с и /Су - компоненты волнового вектора. Если таких слоев много (суперрешетка). То образуются зоны разрешимых состояний для /Сг- В квантоворазмерном кубике-капле квантуются все проекции волнового вектора, а функция плотности состояний превращается в набор б-функций (см. рис. 2.6, в). Таким образом, чисто количественное уменьшение размеров вещества приводит к качественному изменению его квантовомеханических, а также оптических и электрических свойств. Увеличивается ширина запрещенной зоны, снимается вырождение зон для дырок, уменьшается ширина спектра излучения. Порог генерации квантово- [0] [1] [2] [3] [4] [5] [6] [7] [8] [9] [10] [11] [ 12 ] [13] [14] [15] [16] [17] [18] [19] [20] [21] [22] [23] [24] [25] [26] [27] [28] [29] [30] [31] [32] [33] [34] [35] [36] [37] [38] [39] [40] [41] [42] [43] [44] [45] [46] [47] [48] 0.0012 |