
 |
|
Главная Интегральный монолит [0] [1] [2] [3] [4] [5] [6] [7] [8] [9] [10] [11] [12] [13] [14] [15] [16] [17] [18] [19] [20] [21] [22] [23] [24] [25] [26] [27] [28] [29] [30] [31] [32] [33] [34] [35] [36] [37] [38] [39] [40] [41] [42] [43] [44] [45] [46] [47] [48] [49] [50] [51] [52] [53] [54] [55] [56] [57] [58] [59] [60] [61] [62] [63] [64] [65] [66] [67] [68] [69] [70] [71] [72] [73] [74] [75] [76] [77] [78] [ 79 ] [80] [81] [82] [83] [84] 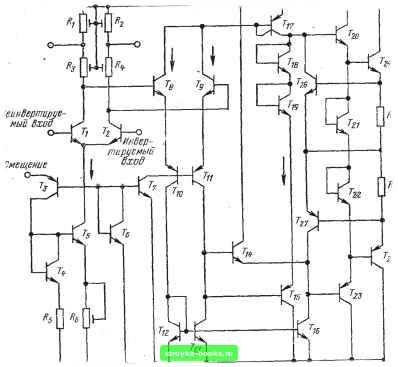 Выход О-Ек Рис. 11-8. Схема операционного усилителя малой мощности (Signetics SE 533). КОМ замыкании (см. рис. 5-14). При изготовлении монолитной схемы, показанной на рис. 11-8, эмиттерные области транзисторов делаются достаточно большими для уменьшения инжекции носителей в боковых направлениях, а слой алюминиевой соединительной металлизации наносится таким образом, чтобы закрыть область перехода база - эмиттер транзистора для уменьшения поверхностной рекомбинации. Схема работает при напряжениях источника питания от ±3 до ±5 В и имеет следующие типовые характеристики: Коэффициент усиления при разомкнутой цепи обратной связи...... . . 90 дБ Напряжение смещения ... 0,5 мВ Ток смещения на входе . . 1 нА Входное сопротивление . . 60 МОм Коэффициент ослаботения синфазного сигнала ... 100 дБ Рассеиваемая мощность: при -ек=±3 В . . . Менее 100 мкВт при £к=+5 В . . . Менее 1 мВт СХЕМЫ, УСТОЙЧИВЫЕ К РАДИАЦИИ 11-4. ВЛИЯНИЕ РАДИАЦИИ НА ИНТЕГРАЛЬНЫЕ СХЕМЫ С точки зрения разработки интегральных схем, устойчивых к радиации, интересно рассматривать два основных типа излучений: 1. Ионизирующая радиация, т.е. рентгеновские лучи и гамма-лучи. 2. Нейтронное излучение. Каждый из этих типов излучений оказывает различное влияние на полупроводниковые устройства и характеристики схем. Ионизирующая радиация Основным видом ионизирующей радиации, которая оказывает влияние на интегральные схемы-, являются гамма-лучи. Количественной мерой воздействия ионизирующей радиации на полупроводниковые устройства является энергия, приходящаяся на единицу объема облучаемого материала. Наиболее широко распространенной единицей ионизирующей радиации является «рад», который представляет дозу радиации, равную Ы0~ Дж на 1 г кремния. Воздействие гамма-излучения приводит к образованию избыточных носителей в кремнии (т. е. электронно-дырочных пар), а также и к повышению температуры. Первый из этих двух факторов имеет более существенное значение, так как он оказывает непосредственное влияние на электрические характеристики схемы. Ионизация, обусловленная гамма-излучениями, может оказывать влияние на работу схемы благодаря одному из трех механизмов: возникновению фототока, полному нарушению работы транзистора и ухудшению свойств поверхности. Влияние ионизирующих излучений на полупроводниковые элементы достаточно хорошо исследовано и описано в литературе. Поэтому в настоящем параграфе излагаются лишь основные результаты этих исследований. Возникновение фототока является наиболее существенным эффектом воздействия ионизирующего излучения. Импульс ионизирующего излучения при воздействии на р-п переход приводит к появлению фототока благодаря образованию электронно-дырочных пар в обедненном слое перехода. Образовавшиеся носители затем дрейфуют или диффундируют через обедненный слой. Движение этих носителей и представляет собой фототек, который сохраняется в течение импульса ионизирующего излучения и затем спадает до нуля. Время спадания фототока после окончания импульса излучения определяется временем жизни т неосновных носителей в полупроводниковом материале. Максимальная величина фототока, обусловленного ионизирующим облучением, пропорциональна площади р-п перехода и возрастает с увеличением интенсивности излучения, измеряемой в рад/с. Хотя возникновение фототока при действии ионизирующего излучения является преходящим эффектом, однако он может привести к временному нарушению работоспособности схемы, и если не предусмотреть ограничения тока в схеме, то устройство может полностью выйти из строя. Поэтому максимальная величина фототока при заданной интенсивности излучения является одним из важнейших проектировочных параметров, который определяет способы защиты схемы от действия фототока. Полученные опытным путем данные показывают, что максимальный фототек, как правило, не превышает величины 25 нА на 1 см площади р-п перехода при интенсивности радиации 0,01 Вт/кг (1 рад/с). Так как величина фототока пропорциональна площади перехода, в обычных интегральных схемах основными источниками, определяющими полную величину фототока, являются переходы коллектор - подложка и коллектор - база, поскольку они имеют наибольшую-площадь из всех р-п переходов монолитных схем. По сравнению-с площадью этих переходов площадь эмиттерно-базового перехода обычно значительно меньше, и поэтому фототоком этого перехода, как правило, можно пренебречь. Если рассматривать транзистор, то фототек, образующийся в переходе коллектор - база, затем умножается в j3 раз и общий ток при этом существенно увеличивается. Этот эффект называют образованием вторичного фототока. На рис. 11-9 показана кривая изменения фототока в цепи коллектора типового п-р-п транзистора при действии импульса излучения 0,5 рад длительностью 0,5 мкс. При этом транзистор переводится в режим отсечки и протекание тока обусловлено только первичным и вторичным фототоком. Из рисунка видно, что  D,Z Dfl- D,B 0,8 Wme Рис. 11-9. Зависимость фототока в цепи коллектора п-р-п транзистора. время запаздывания пикового значения тока и время спада импульса тока, обусловленные временем жизни неосновных носителей, значительно превышают время нарастания импульса. В обычных схемах с диодной изоляцией ионизируюш,ие излучения могут также вызвать явление полного нарушения работы транзистора благодаря тому, что переход между коллектором и подложкой во время действия излучения становится про-водяш,им. Так как переходы между подложкой, коллектором, базой и эмиттером образуют четырехслойную р-п-р-п структуру, ток через переход коллектор - подложка приводит в действие паразитный р-п-р транзистор и . замыкается на подложку (см. рис. 2-2), в результате полностью нарушается работа п-р-п транзистора и он становится прово-,дяш,им. Это явление можно исключить путем применения диэлектрической изоляции вместо диодной. Образование фототока и нарушение нормальной работы п-р-п транзисторов являются обратимыми процессами при условии, если величина полного тока ограничивается при помонхи внешних схемных элементов. Однако ионизируюш,ие излучения могут вызвать и необратимые изменения на границе раздела между полупроводником и окислом. Электронно-ионные пары, образуемые в пассивируюш;ем слое окисла, имеют тенденцию к расхождению, так что у границы раздела полупроводник - окисел остаются только положительные заряды. Эти заряды могут привести к инверсии слаболегированной области р-типа у поверхности. Скорость поверхностной рекомбинации также возрастает, приводя к уменьшению коэффициента усиления р транзисторов при малых токах. Поверхностные изменения, вызванные ионизирующими излучениями, кроме того, ограничивают возможности применения МОП устройств в условиях повышенных уровней радиации. Большинство биполярных схем может работать при воздействии уровней радиации до ГО Вт/кг (1№ рад/с), однако поверхностные изменения в общем случае ограничивают применимость МОП устройств до уровней радиации менее Ш- Вт/кг (10 рад/с). Нейтронное излучение При нейтронном излучении столкновения между нейтронами и атомами кремния приводят к необратимым дефектам в кристаллической решетке кремния. В результате соударений некоторые атомы кремния смещаются из узлов кристаллической решетки. Дефекты такого вида называют «нейтронным смещением». Атомы кремния, смещенные из узлов кристаллической решетки, действуют как центры рекомбинации и рассеивания и приводят к уменьшению времени жизни неосновных носителей и их подвижности. Так как вызываемые нейтронами в кристаллической решетке дефекты носят кумулятивный характер, дозу нейтронного излучения обычно измеряют в единицах полного потока нейтронов, падающего на единицу площади. Образование центров рекомбинации, обусловленное нейтронным смещением, вызывает уменьшение времени жизни неосновных носителей. Так как многие параметры транзисторов, такие, как коэффициент усиления р, обратный ток утечки /ко и время накопления Тн, зависят от времени жизни неосновных носителей, общие характеристики [0] [1] [2] [3] [4] [5] [6] [7] [8] [9] [10] [11] [12] [13] [14] [15] [16] [17] [18] [19] [20] [21] [22] [23] [24] [25] [26] [27] [28] [29] [30] [31] [32] [33] [34] [35] [36] [37] [38] [39] [40] [41] [42] [43] [44] [45] [46] [47] [48] [49] [50] [51] [52] [53] [54] [55] [56] [57] [58] [59] [60] [61] [62] [63] [64] [65] [66] [67] [68] [69] [70] [71] [72] [73] [74] [75] [76] [77] [78] [ 79 ] [80] [81] [82] [83] [84] 0.0012 |