
 |
|
Главная Интегральный монолит [0] [1] [2] [3] [4] [5] [6] [7] [8] [9] [10] [11] [12] [13] [14] [15] [16] [17] [18] [19] [20] [21] [ 22 ] [23] [24] [25] [26] [27] [28] [29] [30] [31] [32] [33] [34] [35] [36] [37] [38] [39] [40] [41] [42] [43] [44] [45] [46] [47] [48] [49] [50] [51] [52] [53] [54] [55] [56] [57] [58] [59] [60] [61] [62] [63] [64] [65] [66] [67] [68] [69] [70] [71] [72] [73] [74] [75] [76] [77] [78] [79] [80] [81] [82] [83] [84] 3-4. РЕЗИСТОРЫ НА БАЗЕ ЭПИТАКСИАЛЬНОЙ /г-ОБЛАСТИ Объемное сопротивление эпитаксиального п-слоя можно использовать для получения некритичных резисторов большого номинала, применяя структуру рис. 3-12. Для ткой структуры, известной как «объемный резистор», удельное сопротивление слоя равно: Ксл - Рэ (3-15) где Рэ - удельное сопротивление и d - толщина эпитаксиального слоя. Для эпитаксиального слоя с удельным сопротивлением 5 Ом-см и толщиной 10 мкм получается удельное сопротивление слоя примерно 5 кОм. Так как объемный резистор создается около перехода эпитаксиальный слой - изоляция, его напряжение пробоя существенно выше, чем у диффузионного резистора. Боковые стенки объемного резистора форМизуются на этапе глубокой изолирующей диффузии, которая происходит не только вниз, но и по брковым направлениям. При вычислении эффективного поперечного сечения объемного резистора следует также принимать во внимание эффекты боковой диффузии. р-изоляции л-эпитаксивльныа слой п*-ксн1лакт  а,) Металл Контакты р-поВлвжт л-эпитаксиалмый слой . Рис. 3-12. Объемный резистор. а - вид сверху; б - поперечное сечение. Температурный коэффициент объемного резистора значительно выше, чем у диффузионного, из-за сильной температурной зависимости подвижности носителей при низкой концентрации примесей. Типичные значения температурных коэффициентов объемного резистора находятся в диапазоне -f5,5-Ю--ь + 5-10~ 1/°С для эпитаксиальных слоев с удельным сопротивлением 1 и 5 Ом-см. Абсолютные значения допусков для объемного сопротивления довольно большие вследствие относительно слабого контроля за эпитаксиальным удельным сопротивлением (20%) и толщиной эпитаксиального слоя (10%). Таким образом, на практике величины абсолютных разбросов объемных резисторов обычно составляют 30%. 3-5. ПИНЧ-РЕЗИСТОРЫ Удельное сопротивление слоя полупроводниковой области может быть увеличено путем уменьшения эффективной площади ее поперечного сечения. Этот метод используется, чтобы получить высокое сопротивление слоя из обычного резистора с базовой диффузией. На рис. 3-13 изображена такая резисторная структура, сформированная при помощи эмиттерной диффузии п+-ти-па в верхней части диффузионного резистора р-типа. Эмиттерная дцф-фузия. существенно уменьшает эффективную площадь поперечного сечения р-резистора и, следовательно, увеличивает удельное сопротивле-  п-зпитаксисшьныи слок Ри?. 3-13. Структурная диаграмма резистора с уменьшенным поперечным сечением.  Рис. 3-14. Резистор с уменьшенным поперечным сечением. а схемные обозначения; б - вольт-амперная характеристика. ние слоя. Результирующую величину Нел можно выразить как Rcji=- Хб- Хэ (3-16) где Хб и Хэ - глубина базовой и эмиттерной диффузии. Среднее удельное сопротивление р эффективного поперечного сечения резистора можно вычислить либо исходя из знания диффузионного профиля, либо путем оценки по данным, приведенным на рис. 3-7. Следует заметить, что эффективная глубина такой структуры равна - ширине базы п-р-п транзистора. Типичные значения Ren такого резистора находятся в диапазоне 5-10 кОм. На рис. 3-14 представлены схемные обозначения и вольт-амперные характеристики пинч-резистора. Обычно р- и п+-области, окружающие такой резистор, закорочены между собой и с выводами- резистора, который находится под более положительным потенциалом, чем остальная структура. Такое соединение, как показано на рис. 3-14,а, обеспечивает обратное смещение на всех переходах, формирующих резистор. Вольт-амперные характеристики пинч-резистора линейны только при небольших значениях напряжения на резисторе. При работе в этом диапазоне прибор ведет себя как линейный резистор с сопротивлением слоя Rca, заданным уравнением (3-16). Более высокое постоянное напряжение на резисторе приводит к увеличению обратного смеще- ния между основной частью резистора р-типа и окружающими п-областями. Это обратное смещение вызывает распространение обедненного слоя перехода в объем резистора и смыкание эффективного поперечного сечения резистора подобно тому, как это .имеет место в полевых транзисторах с затвором на р-п переходе. Следовательно, при увеличении напряжения ток /р пинч-резистора достигает величины насыщения при значении /о, как следует из рис. 3-14,6. Так как верхняя часть резистора образована эмиттерной диффузией с большой концентрацией носителей, резистор обладает низким напряжением пробоя, равным пробивному напряжению эмиттер - база в транзисторе С/эбопр (что составляет обычно 6- 8 В). Сопротивление слоя пинч-резистора имеет сравнительно большой температурный коэффициент - порядка ( + 3-b-f 5) 10-з°С-. Ток насыщения /о также сильно зависит от температуры. Величина его температурного коэффициента- почг ти совпадает с коэффициентом для сопротивления слоя, но имеет противоположный знак. Абсолютную величину сопротивления пинч-рези-сторов трудно контролировать при изготовлении. Типичные значения абсолютных допусков, связанных с Ren и /о, составляют 30-50%. Однако согласование и регулировку идентичных пинч-резисторов на одном кристалле можно выдержать в пределах 6%- Так как эффективная толщина пинч-резистора та же, что и ширина базы п-р-п транзистора, изменения абсолютной величины сопротивления следуют за изменением величины Ро транзистора. Полевой транзистор с захороненным слоем (рис. 3-15) обеспечивает другой метод получения сопротивления большой величины с большим напряжением пробоя, чем у пинч-резистора, полученного в базовой области. В этом случае канал полевого транзистора, который составляет основу резистора, формируется эпитаксиальной областью rt-типа, окруженной со всех сторон р-подложкой, изоляцией и областью базовой диффузии. Удельное сопротивление слоя такого прибора можно выразить как (3-17) где Хб - глубина базовой диффузии; Рэ и d - удельное сопротивление и тол1дина эпитаксиального слоя. Для аналоговых схем область значений Ren находится в пределах 4-8 кОм при температурном коэффициенте примерно 4-10-3 "с-». Поскольку все р-п переходы, сформированные в структуре полевого транзистора с захороненным слоем, легированы незначительно, напряжение пробоя имеет очень высокое значение - порядка напряжения пробоя база - коллектор в транзисторе. Таким образом, резистор такой, структуры особенно подходит для применений в схемах с высоким напряжением. В отличие от резистора с базовой диффузией напряжение смыкания, связанное со структурой полевого транзистора с захороненным слоем, определяется размерами .прибора в горизонтальной плоскости, а также толщиной эпитаксиального слоя. Поэтому его можно конструировать относительно нез.чБИСимо от параметров п-р-п би- р-цзпм/ция 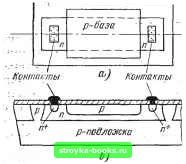 Рис. 3-1S. Полевой транзистор с захоронен-ным слоем. а - размещение элементов прибора; б - поперечное сечение. полярного транзистора. Абсолютная величина и допуск согласования для структур полевых транзисторов с захороненным слоем сравнимы с соответствующими значениями пинч-резисторов на основе базовой области. 3-6. РЕЗИСТОРЫ, ИЗГОТОВЛЯЕМЫЕ МЕТОДОМ ИОННОГО ЛЕГИРОВАНИЯ Метод ионного легирования может использоваться, для создания ре-зисторных структур на поверхности полупроводника. Принципы этого метода были обсуждены в гл. 1 (§ 1-6). При таком методе примеси вводятся в кремниевую решетку путем бомбардировки поверхности кристалла ионами высокой энергии. Внедренные ионы занимают очень тонкий слой (обычно порядка 0,1- 0,8 мкм) вблизи поверхности кремния. Таким образом, при том же количестве примесей удельное сопротивление слоя, полученного методом ионного легирования, приблизительно в 20 раз выше, чем слоя толщиной 2-4 мкм, полученного диффузией примесей. При изготовлении резисторов методом ионного легирования обычно используются структуры р-типа с легированием бором. Для создания определенной геометрии резистора можно использовать толстый оксидный или металлический слой в качестве маски. После этапа ионного легирования кристалл отжигается при сравнительно низкой температуре (обычно от 10 до 20 мин при 500-600°С) для устранения структурных дефектов кремниевой решетки, возникших во время этапа ионного легирования. Сопротивление слоя резистора с ионным легированием обратно пропорционально степени легирования. Конечное значение сопротивления слоя также зависит от времени и температуры последующего отжига, поскольку эта термическая обработка определяет электрическую активность легированных атомов. [0] [1] [2] [3] [4] [5] [6] [7] [8] [9] [10] [11] [12] [13] [14] [15] [16] [17] [18] [19] [20] [21] [ 22 ] [23] [24] [25] [26] [27] [28] [29] [30] [31] [32] [33] [34] [35] [36] [37] [38] [39] [40] [41] [42] [43] [44] [45] [46] [47] [48] [49] [50] [51] [52] [53] [54] [55] [56] [57] [58] [59] [60] [61] [62] [63] [64] [65] [66] [67] [68] [69] [70] [71] [72] [73] [74] [75] [76] [77] [78] [79] [80] [81] [82] [83] [84] 0.001 |